
《华林科纳-半导体工艺》单晶片兆波系统中的二
关键词:兆频超声波清洗,二氧化碳溶解水,粒子去除效率,模式崩溃
介绍
兆频超声波清洗已被用于去除集成电路器件的硅晶片制造中的缺陷,例如颗粒和聚合物/抗蚀剂残留物。然而,随着器件技术节点的缩小,兆频超声波清洗正面临着保持高清洗效率的挑战,这种高清洗效率是由较小颗粒的稳定气穴流动力促进的,而不会产生由瞬态空穴的剧烈内爆引起的图案崩溃。南。活女神等人。报道称,溶解了CO2的水(CO2 DIW)有可能通过最大限度地减少瞬时空腔的无限制爆炸来抑制兆频超声波曝光期间的晶片损坏。这是通过对声致发光的研究来实现的,声致发光是液体被足够强度的声晶片照射时释放光的现象,是空化事件的敏感指标。本文比较了在N2气化水(N2 DIW)中,在大于100纳米尺寸的Si3N4颗粒和纳米节点线/空间图案的兆频超声波功率范围内,CO2溶解对颗粒去除效率和图案塌陷的影响。
实验
实验在300毫米Akrion Systems的金手指速度工具上进行,该工具提供两种不同类型的兆频超声波清洗;前侧(FS)兆频超声波系统,石英棒连接到压电晶体(1.6兆赫),后侧(BS)用塑料覆盖的压电材料(830千赫),如图1所示。二氧化碳(约。1000ppm) DIW和N2(约。20ppm) DIW是使用在一定压力下连续充入CO2或N2的每个膜制备的。对于颗粒去除实验,300毫米的裸硅片被Si3N4颗粒污染(> 100毫米直径,每个晶片大约有20,000个颗粒)。在污染前后和清洗后,由SP1公司(KLA-坦科)从100纳米尺寸开始计数晶片上的颗粒数量。对两种不同类型的多层叠栅多晶硅结构进行了图案塌陷评估;长宽比为9:1的25纳米宽度和长宽比为10:1的35纳米宽度。
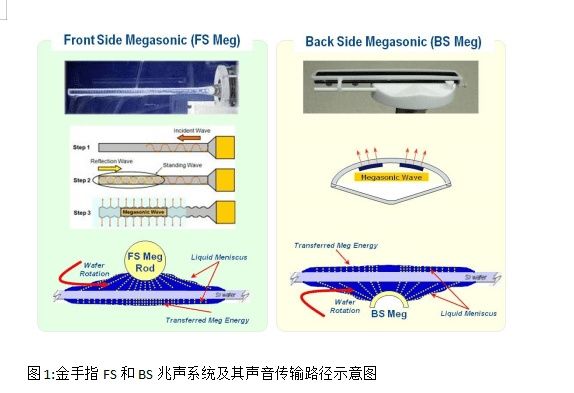
结果和讨论
如图2所示,在0~50W的FS和BS Meg功率范围内,比较了CO2 DIW (RT)和N2 DIW (RT)对Si3N4颗粒的PRE。金手指BS Meg可以通过足够高的PRE同时去除正面和背面的颗粒,就像FS Meg只去除正面的颗粒一样。CO2 DIW显示出比N2 DIW低50%以上的PRE,这与暴露于兆频超声波辐射的DIW的CO2抑制SL生成的能力有关。CO2 DIW的酸性将是CO2 DIW的PRE较低的原因之一;然而,在兆频超声波辐射期间,将稀释的氨水(1:800 =30% NH4OH:DIW)加到晶片表面的CO2 DIW(CO2浓度没有变化)水坑中提供了与N2 DIW相当的PRE。
在0 ~ 50W或BS功率范围内,比较了CO2 DIW和N2 DIW 25nm宽度(AR=9:1)栅极多晶硅晶片的图形塌陷。如错误所示!未找到参考源。CO2溶解大大改善了模式崩溃,在30W Meg功率下零崩溃,其具有> 40%的PRE。在34纳米宽度(AR=10:1)的栅极多晶硅图案上再次评估晶片损伤,以便在使用稀释的NH4OH尖峰来改善CO2 DIW的PRE时观察图案塌陷造成的任何损失。根据表1,即使在大于85%的Si3N4颗粒从硅表面去除的40W BS Meg功率下,也没有发现晶片损坏。结果表明,CO2抑制了DIW的图案塌陷,并且还能够在存在可能导致图案塌陷的其他气体的情况下抑制晶片损伤。