
《炬丰科技-半导体工艺》EUV掩膜表面清洁对光刻
书籍:《炬丰科技-半导体工艺》
文章:EUV掩膜表面清洁对光刻工艺性能的影响
编号:JFKJ-21-933
作者:炬丰科技
?
?
?
?
?
引言
?
极紫外光刻(EUVL)掩模寿命是要解决的关键挑战之一,因为该技术正在为大批量制造做准备。反射式多层掩模体系结构对紫外线辐射高度敏感,容易受到表面氧化和污染。由于各种表面沉积过程造成的EUV标线的污染导致图案形成中图像对比度和曝光宽容度的损失。因此,要获得可使用的掩模寿命,就必须清洁被污染的掩模。为此,正在研究几种口罩清洗方法。
用于极紫外(EUV)光刻的反射式多层掩模结构对表面氧化和污染非常敏感。因此,EUV口罩预计将经历清洗过程,以保持大批量生产所需的寿命。在这项研究中,评估了重复清洁EUV口罩对成像性能的影响。本文使用EUV口罩,其中一个口罩经过反复清洗,另一个作为参考。在每两次清洁之后,监测光刻性能,在工艺窗口分析和线边缘粗糙度方面,并与参考掩模性能进行比较。清洗后,观察到最小的降解。清洁循环将持续进行,直到发现成像保真度明显下降。
?
实验
?
本文完成了两种新的EUV标准掩模的直接成像比较。两种掩模具有相同的多层、覆盖层、吸收剂和抗反射涂层结构。所用的覆盖层是厚度为2.5纳米的钉。任何一个面罩表面的碳污染都应该是最小的,因为在这些成像研究之前,它们还没有被使用过。一种工业开发的清洁工艺在一个掩模上重复使用,而另一个掩模保持原样。
清洁:
标准的湿清洁化学物质被用于清洁面罩的表面。该过程包括三个主要步骤:通过硫酸和过氧化氢的混合物去除有机物、去离子水冲洗和通过SCI的兆频超声波喷雾(去离子水与稀释的氢氧化铉和过氧化氢)进行最终的颗粒清洁。
表面分析:
为了监测钉覆盖层表面的图像,三维掩模在定期清洁期间,使用原子力显微镜获得表面轮廓。
用0.3NA微曝光工具进行掩模构图:
成像是在高级光源同步加速器设备上的MET上进行的。在这里给出的光刻结果中,使用了内部为0.35、外部为0.55的环形照明。
对于两种掩模情况,在没有先前成像或清洁的原始状态下,用基线光致抗蚀剂BBR-07A完成图案化。将该抗蚀剂旋涂到涂有六甲基二硅氮烷(MDS)增粘剂的晶片上产生80纳米标称薄膜厚度。这种抗蚀剂也用于前两次清洗后清洗过的掩模的光刻表征。前两次清洗后,所有
随后的成像使用不同的基线EUV抗蚀剂BBR-08A完成,该抗蚀剂显示具有更高的分辨率。该抗蚀剂在晶片上使用60n-M的膜厚。每个数据集由一个11X11的聚焦和曝光网格组成,称为聚焦曝光矩阵。每个聚焦步骤为50纳米,在整个有限元中给出大约500纳米的聚焦范围,曝光剂量以5%的指数级变化。
?
结果和讨论
?
表面分析:
以固定的清洁周期间隔用原子力显微镜记录的表面形貌进行后处理和分析,以评估任何可检测到的覆盖层损伤。图1显示了清洁过的掩模的覆盖层表面的后处理的自动对焦图像。第一幅图像(左)是在对掩模进行任何清洁之前获得的,并且连续的图像在清洁之间以固定的间隔完成。具体而言,在总共8个清洁周期中,每两次清洁后, 收集图像。
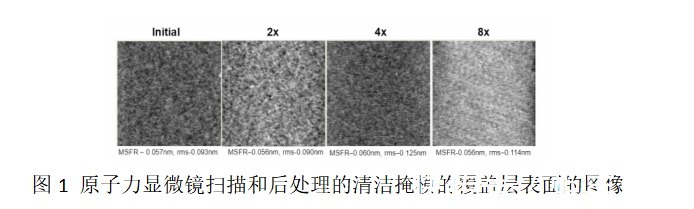
临界尺寸过程分析:
为每个掩模收集两组垂直的、1:1的线和空间图案的工艺窗口数据,一组在40纳米的临界尺寸,另一组在36纳米的临界尺寸。掩模被清洁八次,每两次清洁完成后成像完成。当清洁的掩模被成像时(称为测试掩模),参考掩模也被成像,使我们能够在该研究的长时间跨度内跟踪系统和抗蚀剂效应。该过程产生了11个不同的图案化样品,每个样品上有11×11 FE M,对于这里评估的两个不同的特征宽度给出了22个不同的工艺窗口。
我们完成的第一个比较分析是针对BBR-07A抗蚀剂中记录的图案收集的数据 。将三种情况与这种抗蚀剂进行比较;1)清洁幵始前的测试掩模条件,2)参考掩模性能,3)清洁两次后的测试掩模条件。从表1中列出了收集到的图像,包括等焦距C/D、曝光宽容度(EL)、焦深(DOF)和线边缘粗糙 度(LER)。自由度是根据+/-10%临界尺寸变化过程窗口的椭圆拟合来确定的。为了确定自 由度,椭圆e 1被设置为具有10%的光盘变化。观察到两组图案的等焦距特征宽度在所有 条件下几乎相同,这表明两组图案之后掩模图案没有损坏。两种图案宽度和所有蓿况下的曝光宽容度而自由度数据都显示出小于5 %的变化。这完全在过程不确定性范围内,预计在5%到10%之间。




